電話:86-0755-23229824
手機(jī):18948346937 / 13510373651
地址:深圳市寶安區(qū)沙井街道后亭茅洲山工業(yè)園工業(yè)大廈全至科技創(chuàng)新園科創(chuàng)大廈11層C
微信:
微信客服號:
抖音官方號:
電池片薄膜厚度測量
1.薄膜測量
薄膜是沉積在另一種物質(zhì)表面的非常薄的物質(zhì)層,廣泛應(yīng)用于技術(shù)工藝行業(yè),如鈍化絕緣層、防擴(kuò)散層、硬涂層等。集成電路就主要由薄膜的沉積和選擇性的去除組成。
物理厚度作為薄膜最基本的參數(shù)之一,對整個(gè)器件的最終性能具有重要影響。因此,快速而精確地測量薄膜厚度具有重要的實(shí)際意義。
2.薄膜測量原理
由于光學(xué)測量方法準(zhǔn)確,無破壞,只需很少或無需專門樣品,光學(xué)測量法常常是薄膜測量的首選方法。傳統(tǒng)的測量薄膜物理厚度的光學(xué)方法主要有光度法和橢偏法兩種。橢偏儀測量具有靈敏度高的優(yōu)點(diǎn),但是受界面層等因素的影響,需要復(fù)雜的數(shù)學(xué)模型來求解厚度,上述方法已經(jīng)成功而廣泛地應(yīng)用在各個(gè)領(lǐng)域。然而,近年來微光機(jī)電系統(tǒng)等微加工技術(shù)的發(fā)展,經(jīng)常需要在高低起伏的基板上(patterned substrate)沉積薄膜,因此用測量表面輪廓的白光干涉儀來進(jìn)行薄膜厚度測試的方法引起了人們的關(guān)注。
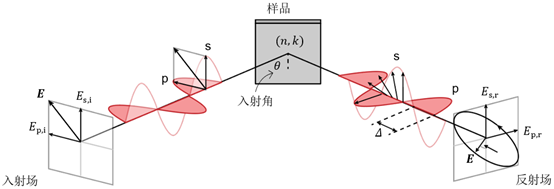
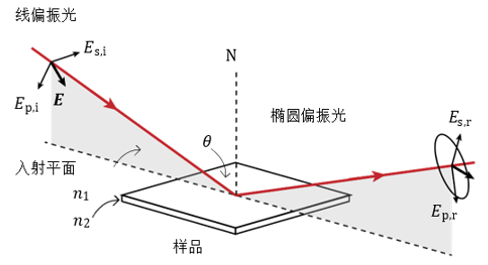
橢圓偏振儀的基本原理
光學(xué)測量是通過精確測量薄膜與光線的相互作用來獲取薄膜特性的技術(shù)。這些特性包括薄膜的厚度、表面粗糙度以及光學(xué)常數(shù)等。通過光學(xué)測量,我們可以將這些光學(xué)常數(shù)與其他材料參數(shù)(如成分和帶隙)相關(guān)聯(lián)。光學(xué)常數(shù)(n和k)描述光如何通過薄膜傳播。在某個(gè)時(shí)間光穿過一種物質(zhì)的電磁場可以簡單表示為

其中x:距離,λ:光波長,n和k:薄膜相應(yīng)的折射率和消光系數(shù)。折射率是光在物質(zhì)和真空中傳播速度的比值。消光系數(shù)是測量光在物質(zhì)中被吸收了多少。
3.光纖光譜儀實(shí)現(xiàn)薄膜厚度測量
當(dāng)入射光穿透不同物質(zhì)的界面時(shí)將會(huì)有部分的光被反射,由于光的波動(dòng)性導(dǎo)致從多個(gè)界面的反射光彼此干涉,這兩部分反射光可能干涉相長(強(qiáng)度相加)或干涉相消(強(qiáng)度相減),這取決于它們的相位關(guān)系。而相位關(guān)系取決于這兩部分反射光的光程差,光程差又是由薄膜厚度、光學(xué)常數(shù)和光波長決定的。

薄膜厚度測量原理示意圖
薄膜測量系統(tǒng)是基于白光干涉的原理來確定光學(xué)薄膜的厚度。白光干涉圖樣通過數(shù)學(xué)函數(shù)的計(jì)算得出薄膜厚度。對于單層膜來說,如果已知薄膜介質(zhì)的n和k值就可以計(jì)算出它的物理厚度。
如下圖為光鍍有折射率為η膜層折射率為n1的基板光路示意圖。使用光纖光譜儀測量薄膜的厚度主要是通過反射光譜,反射光譜曲線中干涉峰的出現(xiàn)是薄膜干涉的結(jié)果。
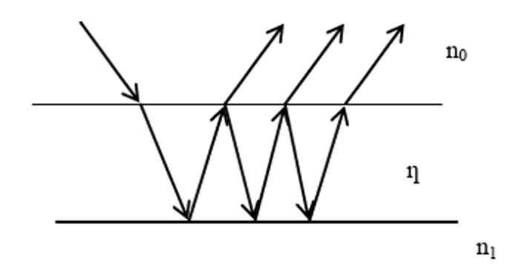
光鍍有折射率為η膜層折射率為n1的基板光路示意圖
4.薄膜測量
為了實(shí)現(xiàn)設(shè)計(jì)功能,薄膜必須有合適的厚度,成分,粗糙度,和特定應(yīng)用的其他重要特性。這些特性往往需要在薄膜的制造過程之中或之后測量。光學(xué)和探針測量是薄膜測量的兩種主要類型。
基于白光干涉理論,利用萊森光學(xué)光纖光譜儀可以實(shí)現(xiàn)薄膜的高精度測量。這種測量方法通過正角度入射的反射率來獲取薄膜的厚度和折射率信息,并通過提取光入射薄膜前后的相位變化來進(jìn)行計(jì)算。相比傳統(tǒng)的光度法和偏法,這種測量方法具有更高的精度和更快的測量速度,同時(shí)結(jié)構(gòu)簡單、成本低廉,為光學(xué)薄膜厚度的測量提供了一種簡便、快速且可靠的解決方案。

光纖光譜儀薄膜測量原理示意圖

反射探頭光路圖
5.實(shí)驗(yàn)
5.1實(shí)驗(yàn)?zāi)康?/strong>
測量400-1000nm電池片樣品薄膜厚度。
測量兩個(gè)樣品的薄膜厚度,每個(gè)樣品兩層膜的厚度測量。樣品膜系結(jié)構(gòu)是硅基底上鍍了一層厚的氧化硅,在上面是poly-si膜層。si|siox|poly-si,最外層poly-si。

圖1 樣品圖片
5.2實(shí)驗(yàn)儀器列表

5.3實(shí)驗(yàn)內(nèi)容
薄膜厚度設(shè)備測量示意圖:

圖2 光路實(shí)驗(yàn)示意圖

圖3 光路實(shí)驗(yàn)實(shí)物圖
5.4實(shí)驗(yàn)結(jié)果
以下計(jì)算薄膜的算法使用的是光譜白光干涉,擬合使用L-M擬合。計(jì)算結(jié)果如下:
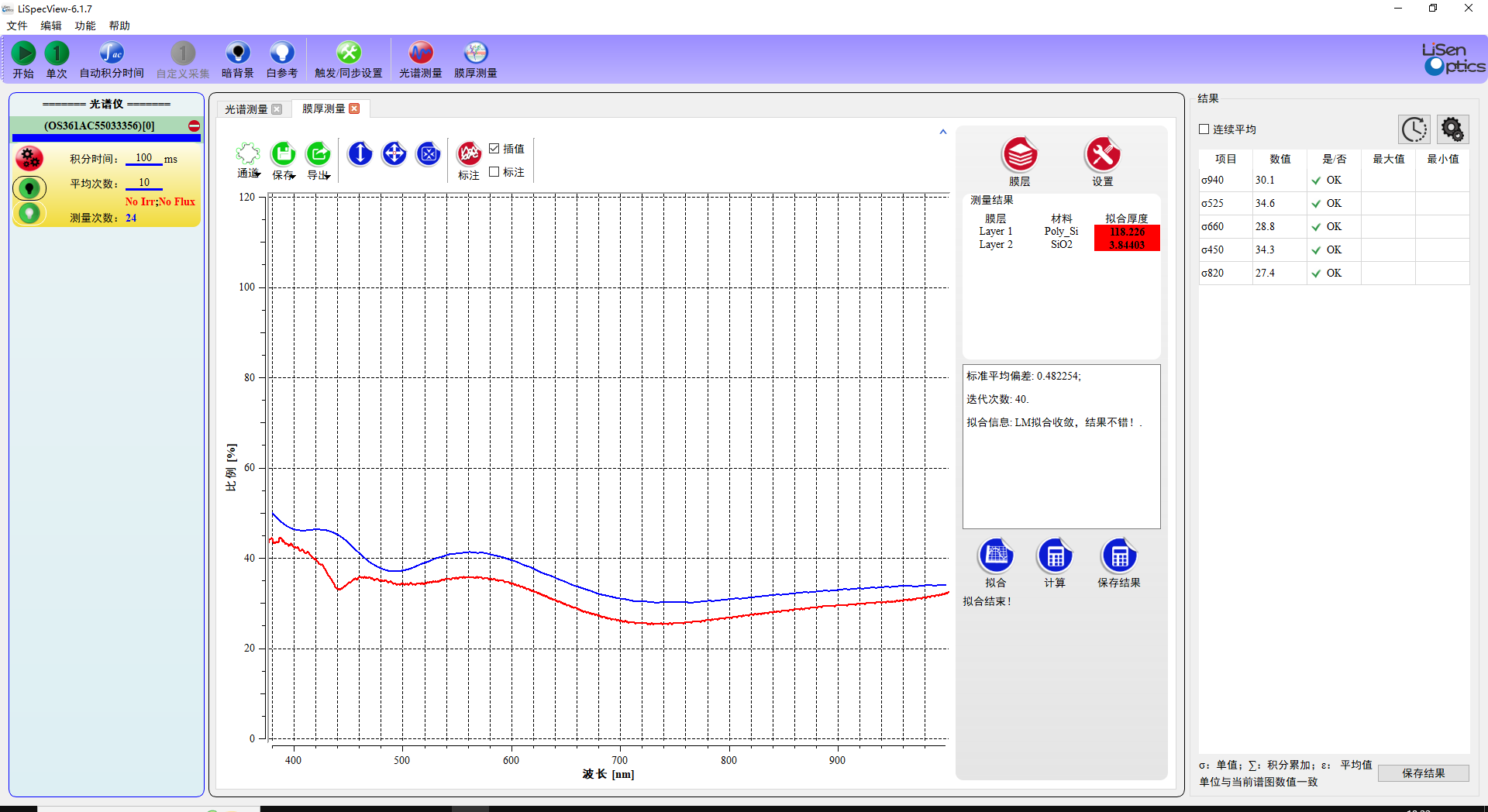

測試條件:模擬傳送帶狀態(tài)下,每1分鐘擬合厚度,擬合十次。
模擬厚度的相對標(biāo)準(zhǔn)差:1.158%,2.738%

測試條件:靜止?fàn)顟B(tài)下,每5分鐘保存一組反射率,測量10組。
測試結(jié)果:穩(wěn)定性(相對標(biāo)準(zhǔn)偏差:0.76306%)

測試條件:模擬傳送帶狀態(tài)下,每5分鐘保存一組反射率,測量10組。
測試結(jié)果:穩(wěn)定性(相對標(biāo)準(zhǔn)偏差:4.944%)
6.結(jié)論
通過數(shù)據(jù)得出測量Poly-si的厚度為120nm±2nm,SiO2的厚度為5nm±1nm。